EDA365电子工程师网
标题: SiP封装工艺6—Wire Bonding [打印本页]
作者: admin 时间: 2019-9-27 15:51
标题: SiP封装工艺6—Wire Bonding
========内含视频,建议WiFi环境下观看========
+ k {6 n! j% M
Plasma Clean (电浆清洗Before WB). U7 ~, r6 P/ x6 e# Y
在密闭真空中充入少量Ar、H2、O2中的一种或几种气体,利用RF power在平形板电极形成电场使电子来回震荡,电子激发并电离气体产生电浆,撞击基板和芯片表面,与污染物产生物理或化学反应,利用气体流通将污染物去除。电浆清洗使表面微结构产生官能基或达到一定的粗糙度,增加不同材料之间的结合力,增加焊点的可靠性以及基板与塑封材料之间的结合力,从而提高产品的可靠度、增加使用寿命。
5 K; T- k. K( a0 F( v& M& f1 U3 {
. Q6 Y9 l% V& U1 z; ^. O) s/ K9 F# u" b& fPlasma Clean示意图
电浆清洗主要分以下几种
6 v" \. A) c) p, e1 F: i, z1. Argon Plasma* L1 B$ g0 i& V9 v0 r O, V6 s
纯物理作用、物理撞击可将表面高分子的键结打断,形成微结构粗糙面。/ Q( |: P0 K/ q2 V8 \1 m2 v1 c
2. Oxygen Plasma0 }! b! q/ K- ^
具有化学作用,可以氧化燃烧高分子聚合物,或者形成双键结构的官能子,可表面改性。
" l. W/ _1 y+ d" ]7 w6 j7 b. Q3. Hydrogen Plasma& }7 R+ u, R( q- s' z+ e$ V7 k
具有还原性作用的气体,可以还原被氧化的金属表面层。- @3 ~) A5 X4 D# w5 ?7 W: |& B U9 D" T2 U
4. Mix Gas Plasma
, u# e) j) b# b6 w" G5 z! d# c 组合上述气体种类,可达到特殊官能基的形成。Ar & H2混合气,借由物理撞击对表面的结构产生活化作用,并形成粗糙面增加结合力。Wire Bond工序前,采用此种清洗方式,可以增加焊点的结合力。O2& H2混合气,对金属面形成OH-基,Molding 工序前,采用此种清洗,可以增加与 Compound间的结合力。
+ k! v% V2 g/ W[url=]
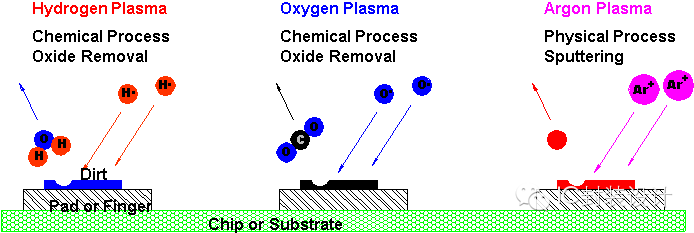
$ B4 t E) w, S0 R' f Y$ ][/url][url=]电浆清洗三种原理[/url]
[url=]
" n' D4 N- b" `8 e ~[/url]
5 a. }) w/ L6 X1 d8 ]1 j J) T! C3 x4 j& i4 l( w
& d3 ]0 Q3 o; F. E& _! NPlasma Clean (电浆清洗Before WB)4 k8 ^ O6 V* s! K$ Z0 t! E* J
WB是封装工艺中最为关键的一步,主要目的是利用金线(Au)、铝线(Al)或铜线(Cu),把芯片上的Pad和基板上Finger通过焊接的方法连接起来。焊接方式有热压焊、超声键合和热超声焊等,这里主要介绍热超声焊。
; q6 R7 S1 C2 ]( \热超声焊的主要材料为金线,成分为99.99%的高纯度金,线径一般为0.8mil,1.0mil,1.3mils,1.5mils和2.0mils等。利用超声振动提供的能量,使金丝在金属焊区表面迅速摩擦生热,产生塑性变形,破坏金属层界面的氧化层,两个纯净的金属界面紧密接触,在钢嘴压力作用下,达到原子间紧密键合,形成牢固的焊接。
# e$ l* @% _8 Z! t# p. _9 U7 }( s8 X+ M x" c( k! ~7 n" [8 j; z
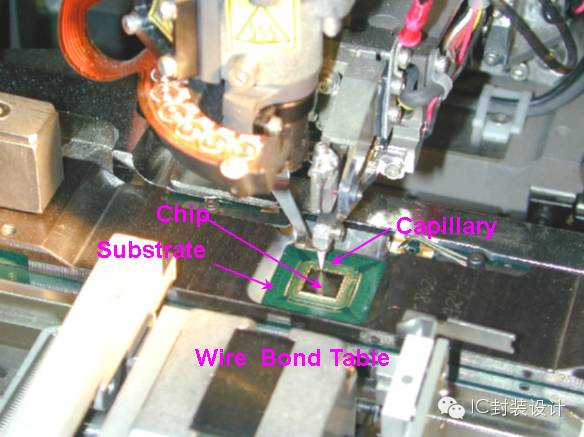 9 h" Y9 b9 o) b; T% l, f8 L
9 h" Y9 b9 o) b; T% l, f8 L
热超声焊
' `9 p3 L Z" c x2 a j球焊的主要过程如下图:4 F0 h5 c8 m' d. G
1) 打火杆在瓷嘴前打火,将金线烧熔成球;! K! r5 ?- `1 a# V' R8 b3 a# w
2) 第一焊点:金球在钢嘴施加的一定压力和超声的作用下,与芯片pad连接,形成焊球(Bond Ball);
6 U, I* B8 S, y+ V, D3) 第一焊点完成后,夹持金线的夹子松开,钢嘴牵引金线上升,并按程序设定的轨迹运动,从而形成一定的线型(Wire Loop)。7 ]" c* t7 w* m4 A! Q$ [& G/ D- c
4) 第二焊点:钢嘴运动到基板Finger上方,在超声作用下,下压到在基板的Finger上,形成鱼尾(Wedge)形的连接;: A! k1 ? J( ?' j3 V$ |
5) 第二焊点完成后,钢嘴向上运动,拉出一定长度的金线(为下一步烧球做准备),夹子闭合,金线与Finger的连接被切断。, r! _5 u/ y: y3 L( H
6) 回到第1),进入下一焊接循环。
0 i) k4 c7 r; M$ n1 h" yWB四要素:压力(Force)、超声功率(USG Power)、时间(Time)、温度(Temperature)。
9 I0 [: t$ F- L* w
0 W3 L+ F1 r' {8 ^5 t m3 Z
: K/ @6 l& k" q
* Q2 u' z9 v# I& N9 [ ~
1 W: W! x2 Y& d" I5 x; ~: _[url=]金丝球焊过程示意图及焊接[/url]后的基板和芯片、金丝及第一、第二焊点图
0 H% `7 M) q8 o |0 G
9 f4 U: h: ] C5 G% [$ K& C: [6 C
& P6 c; w5 r" I9 d. q1 J0 ^8 i, |1 w) J5 P1 K' I0 j4 }1 q# z2 p! K$ a
# U7 F0 G+ R( M v
& I4 v1 x% t$ g% X: T8 ]
+ ^1 C) E* J# \+ j9 o3 @- g# |
6 Q/ t0 P. r" |% A9 F! W; M4 f/ @/ {0 h, s$ A5 P
下一节我们会继续SiP的工艺流程Molding(注塑),敬请关注。. f1 y: W% F2 Z; E. ^! s
7 u" D7 g9 _* t7 Y! a/ @$ [- J1 ^
1 S e! ~" `' o' `2 ]' ^更多精彩,请加“IC封装设计”技术交流微信群!; p, [2 W7 V+ L3 z0 G
加入方法:加群主微信auhijnap,注明公司,姓名,技术专长,验证加入。
7 O* C! y5 L" ?学习,交流,分享IC封测技术,包括但不限于设计,仿真,工艺,可靠性...
: I8 F4 O) i T& w
8 u- z, c# L% R) O2 J国内主要IC,封测,载板厂商已到齐,台日韩封测载板厂家正在邀请...
( c' [) G+ K4 `5 D9 t; L* O# O已加入厂商(部分):3 C" r+ d4 {6 D+ z
兴森、越亚、深南、康源……
+ V, o4 F3 P% H0 {( o8 \3 Y- v9 c+ G. q
长电、华天、通富、晶方、芯健......5 U9 f' v1 R* J8 K6 T
展讯、华为、中兴、联芯、全志、联想、国科、芯源、灿芯、锐迪科、瑞芯微、景嘉微、汉天下、新岸线、国民技术……% F4 ~; l7 \8 n' y7 g2 A
ASE, Amkor, PTI, SPIL, UTAC, STATS ChipPAC, Unisem, Sandisk, Shunsin, Qorvo, Micron, Ramaxel, MTK, Synaptics, Goodix ……
; [! ?3 Y: A& Q) g) U) N& r2 D2 p. XAnsys, Keysight, Cadence……
| 欢迎光临 EDA365电子工程师网 (http://bbs.elecnest.cn/) |
Powered by Discuz! X3.2 |


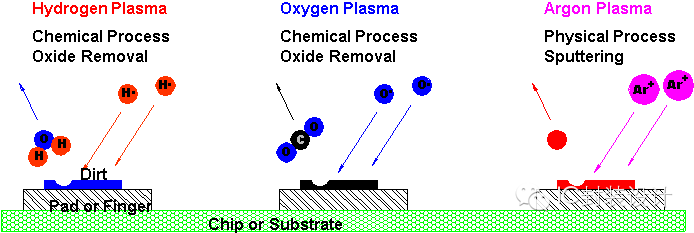
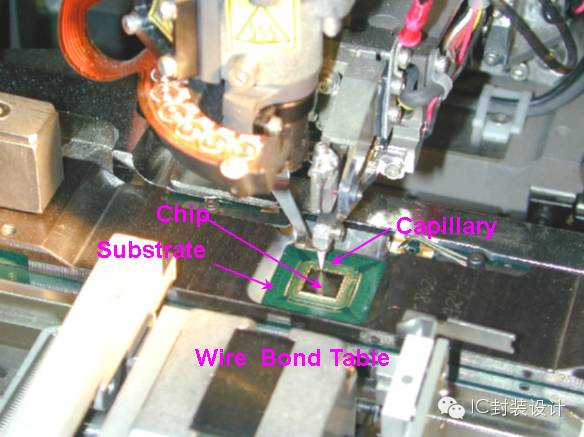 9 h" Y9 b9 o) b; T% l, f8 L
9 h" Y9 b9 o) b; T% l, f8 L